在近日举办的2025 Intel Foundry Direct Connect大会上,英特尔详细披露了其2.5D桥接先进封装技术EMIB的最新进展,这些信息通过英特尔的官方演讲和德国知名硬件媒体Hardwareluxx编辑Andreas Schilling拍摄的现场图片得以广泛传播。
活动中,英特尔首次公开了EMIB技术的新变种——EMIB-T。这里的“T”代表着硅通孔(TSV)技术,显示了英特尔在封装技术上的进一步创新。同时,英特尔还介绍了采用RDL重布线层和Bridge桥片的Foveros-R与Foveros-B封装技术,为芯片封装提供了更多选择。
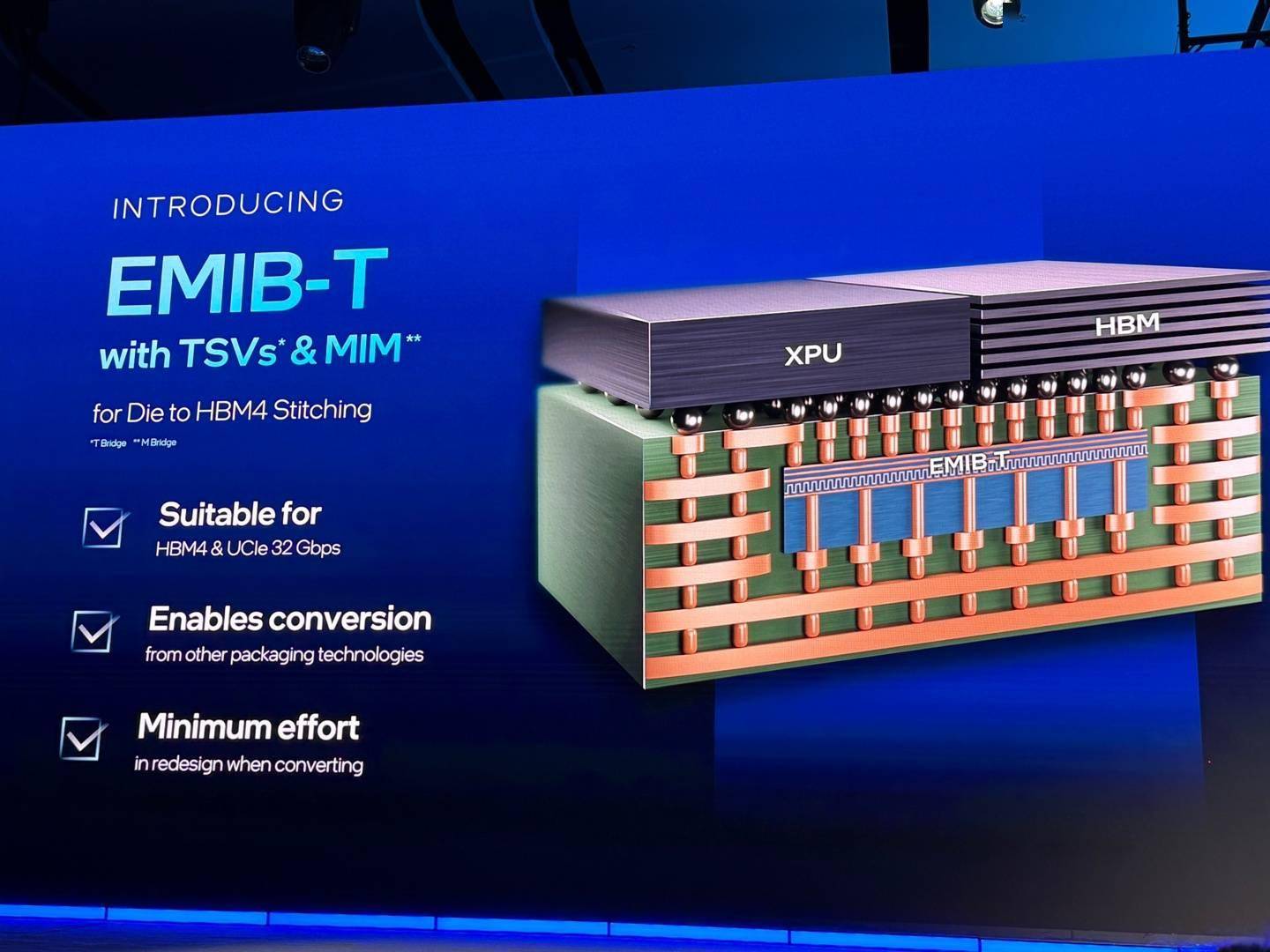
EMIB-T技术特别针对HBM4和UCIe芯片集成进行了优化,通过TSV和M Bridge技术在基板中构建了垂直电力通道,有效避免了传统方案中的“绕路”问题。这一改进不仅降低了直流和交流电噪声,还显著提升了信号传输的稳定性,为高性能计算领域带来了福音。
英特尔强调,EMIB-T技术能够支持从其他2.5D先进封装技术的平滑迁移,且无需进行重大的重新设计,这对于希望在现有基础上升级封装技术的厂商来说无疑是个好消息。

展望未来,英特尔透露了EMIB技术的宏伟蓝图。到2026年,通过超过20个EMIB桥的连接,将能够实现约120mm×120mm的总封装尺寸,集成多达12个HBM内存堆栈。而到了2028年,封装尺寸将进一步扩大至120mm×180mm,HBM数量也将突破24个,展现出英特尔在封装技术领域的深厚积累和前瞻布局。